英特尔近些年在CPU制造工艺上遇到瓶颈停滞不前,但这Intel在芯片封装工上也是没有停下步伐,近些年也是推出了各种先进的封装技术,其中包括我们熟悉的3D Foveros封装技术、横向拼接Co-EMIB技术等等。

而英特尔最近推出了一种全新的“混合键合”(Hybrid Bonding),这套技术可做到更小的凸点间距,并且可取代当今大多数封装技术中使用的“热压结合”工艺。

根据英特尔介绍,混合键合技术能够加速实现10微米及以下的凸点间距(Pitch),提供更高的互连密度、更小更简单的电路、更大的带宽、更低的电容、更低的功耗(每比特不到0.05皮焦耳)。

Intel目前的3D Foveros立体封装技术,可以让逻辑芯片可以堆叠在一起,而其中的凸点间距在50微米左右,每平方毫米集成大约400个凸点,而应用新的混合键合技术,凸点间距缩小到10微米,每平方毫米的凸点数量更能达到1万个,增加了足足25倍。

目前采用混合结合封装技术的测试芯片已于2020年第二季度流片,不过Intel没有透露会在哪些产品上使用这项技术。
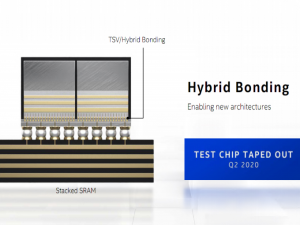 英特尔推出Hybrid Bonding混合键合封装技术 芯片凸点数量提升25倍
英特尔推出Hybrid Bonding混合键合封装技术 芯片凸点数量提升25倍 Flying195
Flying195














 沪公网安备 31010702005758号
沪公网安备 31010702005758号
发表评论注册|登录